旭化成开发出面向先进半导体封装的全新感光干膜“SUNFORT™”
~面向AI服务器的重新布线层实现进一步微细化,采用LDI曝光实现1.0μm宽度图形~
旭化成株式会社(总公司:东京都千代田区,总经理:工藤幸四郎,以下简称“本公司”)于2025年5月开发出可应用于AI服务器等先进半导体封装制造工艺的全新感光干膜“SUNFORT™ TA系列”(以下简称“TA系列”)。感光干膜是本公司电子业务的核心产品之一,而此次推出的“TA系列”旨在应对快速增长的下一代半导体封装市场需求。该系列产品不仅适用于传统的Stepper曝光设备※1,还可对应LDI(激光直写)曝光设备※2,在两种曝光方式下均能实现极高的图案解析度,有助于在封装工艺中提升基板微细线路图案的成型性能。
 感光干膜“SUNFORT™”
感光干膜“SUNFORT™”
本公司在《中期经营计划2027 ~Trailblaze Together~》中将电子业务定位为重点增长业务之一。电子业务由电子材料业务和电子元件业务这两部分组成,“SUNFORT™”是电子材料业务的核心产品之一。
用于AI服务器等先进半导体封装的中介层(Interposer)※3及封装基板,不仅需要具备大面积、高多层的结构特性,同时对高密度微细线路的形成技术也有很高要求。作为形成这些微细线路的再配线层(RDL),长期以来由于解析度的限制,液态光刻胶一直为主流材料。然而,相较于液态光刻胶,感光干膜在适配面板尺寸、易操作性、可同时对基板正反面进行处理等方面具有显著优势。尽管如此,由于解析度不足,感光干膜一直未能应用于RDL的形成工艺中。
本次基于多年积累的感光性材料技术和全新的材料设计开发而成的“TA系列”产品,在RDL形成所需的4μm节距设计条件下,可通过LDI曝光实现1.0μm线宽的图案形成,是非常适用于面板级封装※4等微细配线形成的感光干膜材料(见图a、b)。所形成的微细光刻图案,经过SAP(加成法)※5电镀图案形成工艺以及后续光刻胶剥离步骤后,可在4μm节距设计条件下实现3μm线宽的电镀图案形成(见图c)
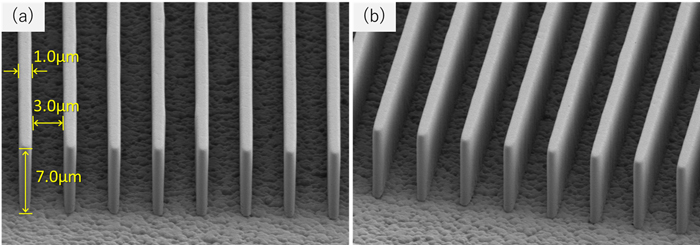 通过LDI曝光形成的7µm厚TA系列微细图形示例
通过LDI曝光形成的7µm厚TA系列微细图形示例
(a) 正面视图:干膜形成图形(线宽/线距=1.0/3.0µm)
(b) 斜视图:干膜形成图形(线宽/线距=1.0/3.0µm)
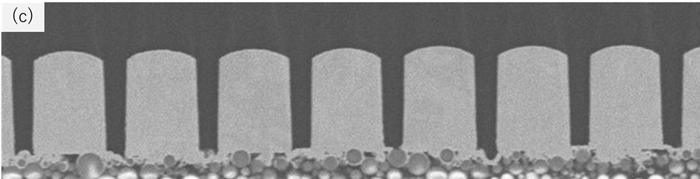 (c) 干膜剥离后横截面图:电镀图案(线宽/线距=3.0/1.0µm)
(c) 干膜剥离后横截面图:电镀图案(线宽/线距=3.0/1.0µm)
此外,“TA系列”亦可对应传统的Stepper曝光方式,为日益多样化的微细线路形成工艺提供新的选择。
今后,本公司的感光干膜“SUNFORT™”将继续为伴随面板尺寸大型化而日益重要的面板级封装技术开发作出贡献。
- 参考:感光干膜“SUNFORT™”的详细信息,请参阅网页https://www.asahi-kasei.co.jp/sunfort/en/products/ta.html。
- ※1 也称为“步进式曝光装置”,是一种将玻璃光罩上的图案以缩小投影方式曝光至晶圆上的方法。
- ※2 利用激光技术,在基板上实现高速且高精度曝光的方法。
- ※3 用于连接半导体芯片和电子元器件的中间基板。
- ※4 在半导体芯片封装过程中,与传统的圆形晶圆不同,采用大型方形面板基板的先进封装技术。
- ※5 在种子层(化学镀铜或溅射铜)上用抗蚀膜形成非线路图案,通过电镀形成线路,随后通过蚀刻去除多余种子层的工艺方法。
旭化成株式会社
2025年5月26日
